近日,第九届国际第三代半导体论坛在厦门国际会议中心召开,论坛以“低碳智联同芯共赢”为主题。新一代半导体材料集成攻关大平台主任徐现刚教授作为碳化硅功率电子分论坛主席受邀出席,大平台徐明升教授受邀参加“碳化硅功率器件及其封装技术”分会并作报告。

图:徐明升教授参加第九届国际第三代半导体论坛现场
徐明升教授作“SiC的高温氧化研究”主题报告,分享了最新研究成果,涉及栅极氧化、沟槽MOS管等。他讲到SiC材料具有优异的高温稳定性、耐腐蚀性、热导性能和机械强度等优势,因此受到广泛关注和应用;高质量SiC氧化技术是SiC器件的关键核心工艺,通过不断优化SiC氧化工艺,可以进一步提高SiC功率器件的质量和性能,推动碳化硅功率器件在电动汽车等领域的广泛应用。

图:徐明升教授作“SiC的高温氧化研究”报告

图:徐明升教授作“SiC的高温氧化研究”报告

图:徐明升教授关于SiC的高温氧化研究报告内容
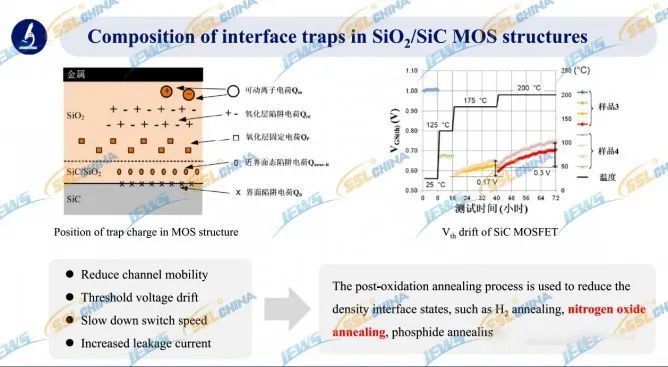
图:徐明升教授关于SiC的高温氧化研究报告内容
徐明升教授做详细实验数据分析,他表示SiC沟槽MOSFET具有优异的耐高压、大电流特性,器件开关损耗比Si基IGBT低约77%。SiC MOSFET器件的阈值电压漂移影响了其广泛的应用,其根本原因是栅极氧可靠性差,栅极氧化是影响SiC MOSFET器件广泛应用的关键问题。

图:徐明升教授关于SiC的高温氧化研究报告内容

图:徐明升教授关于SiC的高温氧化研究报告内容
报告最后,徐明升教授讲解了高温氧化研究方面近界面陷阱的密度、界面陷阱电荷、TEM横截面图、栅极氧化物厚度均匀性;沟槽MOS晶体管研究方面,涉及SEM俯视图、欧姆接触、器件性能等内容。详细分析4H-SiC在1250°C下的氧化,厚度~45nm,SiO2和SiC之间的NITs: ~ 1.68×1010 cm-2,击穿电场为9.7MV/cm,势垒高度为2.59eV等研究内容。